1.实验程序介绍
打开Silvaco软件中的deckbulid程序运行窗口,并调入基本模拟程序,如图4。

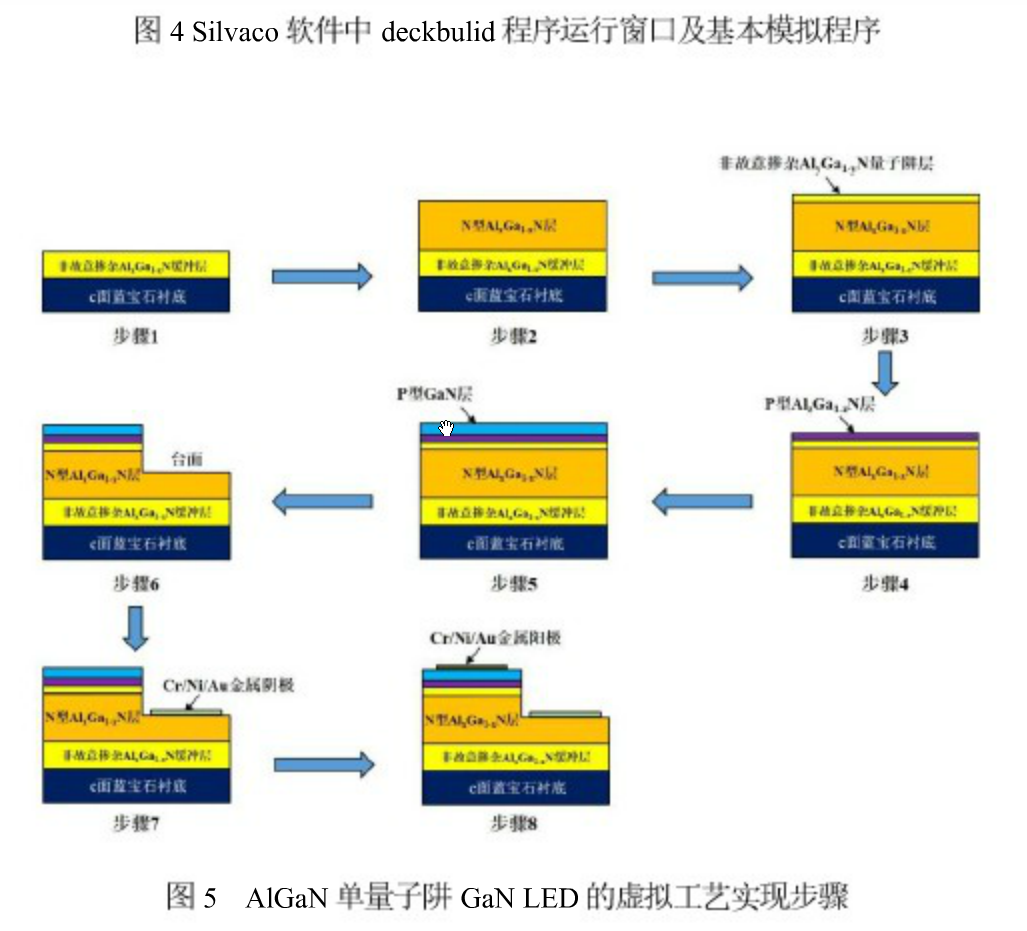
本项目实验程序主要由虚拟工艺和器件特性仿真两部分组成,虚拟工艺部分用于实现AlGaN单量子阱GaNLED器件结构,器件特性仿真部分用于进行器件光电特性仿真分析。图5给出了AIGaN单量子阱GaN LED的虚拟工艺实现步骤,具体虛拟工艺步骤及器件结构和材料参数如下:
步骤1:在c面蓝宝石衬底上,采用MOCVD外延厚度为hu (1μmsh≤4um)、 Al组分为x (0.2 步骤2:在Al,Ga-xN缓冲层上外延厚度为h2 (0.2μmsh2≤1μm)、掺杂浓度为Ni(5x 10l7cm-3ζNi≤1x10'9cm-3)、Al组分x与AlxGa-xN缓冲层相同的N型Al,Ga.xN层;
步骤3:在N型Al,Ga-xN层上外延厚度为h;(2nmSh;≤10nm)、Al组分为y(0.1≤ys0.6)的非故意掺杂AlyGa.-yN量子阱层;
步骤4:在Al,Gar-yN量子阱层上外延厚度为h4 ( 5nmSh4≤50nm)、Al组分为z(0.3≤z<0.8)、掺杂浓度为N2 (5x 10l6cm3 步骤5:在P型Al2Ga-N层上外延厚度为hs (20nmshs<200nm)、掺杂浓度为N;(1x 10l7cm-3≤N;≤1x1029cm-3)的P型GaN层;
步骤6:采用干法刻蚀工艺,在所制备的外延层上进行干法刻蚀,制作台面结构,下台面位置应低于非故意掺杂Al,Ga-N量子阱层与N型AlxGa-xN层的异质界面;
步骤7:在下台面N型Al,Ga1.xN层上制作Cr/Ni/Au金属阴极; .
步骤8:在上台面P型GaN层上制作Cr/Ni/Au金属阳极,完成整个AlGaN单量子阱GaNLED器件的制作。在获得AlGaN单量子阱GaN LED器件样品后,进行器件光电特性仿真,利用TonyPlot看图软件分析器件的I-V特性、I-L特性、EL谱特性的特点和规律,并利用TonyPlot看图软件给出各器件样品中的能带结构图、载流子浓度分布图、载流子复合率分布图等,剖析Al组分影响器件光电特性的物理机制,最后利用Origin专业数据处理软件对仿真结果进行处理,形成实验报告。
2.实验方法与步骤.
在氮化镓发光二极管的虚拟仿真中,学生可以根据需要设置器件的结构和材料参数,同时也可以改变器件的阳极和阴极偏置电压,在保持其他参数不变情况下,改变其中一个参数,分析器件的光电特性和规律。这里针对本实验教学项目中AlGaN单量子阱GaNLED器件典型虚拟仿真实验案例重点说明具体实验方法和步骤,实验中通过改变非故意掺杂AlyGa1yN量子阱层的Al组分,获得不同器件样品,分析Al,Ga-yN量子阱层Al组分对器件光电特性影响和规律。
(1)AIGaN单量子阱GaN LED器件的虚拟工艺实现过程
①非故意掺杂AI,Ga-yN量子阱层的AI组分y取0.3时器件的虚拟工艺实现过程。
步骤1:在c面蓝宝石衬底上,采用MOCVD外延厚度h1=2μm、Al组分x=0.4的非故意掺杂Al.Ga-xN缓冲层;
步骤2:在Al,Ga-xN缓冲层上外延厚度h2=0.53μm、掺杂浓度Ni=1x10l8cm3、Al组分x=0.4的N型Al,Ga-xN层;
步骤3:在N型Al,Ga1xN层上外延厚度h;=3nm、Al 组分y=0.3的非故意掺杂Al,Ga-yN量子阱层;
步骤4:在Al,Ga-yN量子阱层.上外延厚度h4=10nm、Al组分z=0.5、掺杂浓度N2=1x1020cm-3的P型Al2Ga-zN层;
步骤5:在P型Al2Ga1-zN层上外延厚度hs-80nm、掺杂浓度N3=1x1029cm-3的P型GaN层;
步骤6:采用干法刻蚀工艺,在所制备的外延层上进行干法刻蚀,制作台面结构,下台面位置应低于非故意掺杂Al,GaryN量子阱层与N型AlrGa1-xN层的异质界面;
步骤7:在下台面N型Al,Ga-xN层上制作Cr/Ni/Au金属阴极;
步骤8:在上台面P型GaN层上制作Cr/Ni/Au金属阳极,完成量子阱层A1组分取0.3的AlGaN单量子阱GaNLED器件的制作。
②非故意掺杂Al,GaryN量子阱层的AI组分y取0.4时器件的虚拟工艺实现过程。
步骤1:在c面蓝宝石衬底上,采用MOCVD外延厚度h=2um、Al组分x=0.5的非故意掺杂Al,Ga-xN缓冲层;
步骤2:在Al,Ga-xN缓冲层上外延厚度h2= =0.53μum、掺杂浓度Ni=1x10l&cm~3、Al组分x=0.5的N型AlxGa-xN层;
步骤3:在N型AlxGa-xN层上外延厚度h;=3nm、Al 组分y=0.4的非故意掺杂Al,Ga.-yN量子阱层;
步骤4:在AlyGa1-yN量子阱层上外延厚度h4=10nm、Al组分z =0.6、掺杂浓度N2=1x1020cm3的P型Al,Ga.2N层;
步骤5:在P型Al,Ga1-2N层上外延厚度hs=-80nm、掺杂浓度N=1x 1020cm-3的P型GaN层;
步骤6:采用干法刻蚀工艺,在所制备的外延层上进行干法刻蚀,制作台面结构,下台面位置应低于非故意掺杂Al,Ga-yN量子阱层与N型AlxGa-xN层的异质界面;
步骤7:在下台面N型Al,Ga-xN层上制作Cr/Ni/Au金属阴极;
步骤8:在上台面P型GaN层上制作Cr/Ni/Au金属阳极,完成量子阱层A1组分取0.4的AlGaN单量子阱GaNLED器件的制作。
③非故意掺杂Al,Ga-N量子阱层的AI组分y取0.5时器件的虚拟工艺实现过程。
步骤1:在c面蓝宝石衬底上,采用MOCVD外延厚度hn=2um、Al 组分x=0.6的非故意掺杂Al,Ga-xN缓冲层;
步骤2:在AlxGa-xN缓冲层上外延厚度h2=0.53um、掺杂浓度N=1x 10l8cm-3、Al组分x=0.6的N型AlxGa-xN层;
步骤3:在N型AlxGa-xN层上外延厚度h;=3nm、Al 组分y=0.5的非故意掺杂Al,Ga-yN量子阱层;
步骤4:在AlyGa-yN量子阱层上外延厚度h4=10nm、A1组分z= =0.7、掺杂浓度N2=1x102*cm3的P型Al2Ga1-2N层;
步骤5:在P型AlzGa12N层上外延厚度hs=80nm、掺杂浓度N3=1x 102*cm3的P型GaN层;
步骤6:采用干法刻蚀工艺,在所制备的外延层上进行干法刻蚀,制作台面结构,下台面位置应低于非故意掺杂Al,Gar3)N量子阱层与N型Al,Ga-xN层的异质界面;
步骤7:在下台面N型Al,Ga1xN层上制作CrNi/Au金属阴极;
步骤8:在上台面P型GaN层上制作Cr/Ni/Au金属阳极,完成量子阱层Al组分取0.5的AlGaN单量子阱GaNLED器件的制作。
(2)AIGaN单量子阱GaN LED器件光电特性的虚拟仿真和分析利用器件特性仿真语句仿真Al,GaryN量子阱层的Al组分分别为0.3、0.4、 0.5时,器件样品的光电特性。具体步骤如下:
步骤1:仿真Al1,Ga.yN量子阱层A1组分y取0.3时器件的IV特性、IL特性、EL谱特性,获得仿真结果;
步骤2:仿真Al,Ga-yN量子阱层Al组分y取0.4时器件的I-V特性、I-L特性、.EL谱特性,获得仿真结果;
步骤3:仿真Al,Ga.yN量子阱层Al组分y取0.5时器件的I-V特性、IL特性、EL谱特性,获得仿真结果。
步骤4:器件阴极的偏置电压设置为0V,设置器件阳极偏置电压为5.5V时,仿真Al,GaryN量子阱层Al组分y取0.3时器件内部电流密度分布情况,获得仿真结果。
步骤5:综合比较和研究步骤1~3中各器件的I-V特性、IL特性、EL谱特性, 分析Al,GaryN量子阱层的Al组分对器件光电特性的影响和规律,分析步骤4中器件内部电流密度分布特点和规律,并利用仿真得到能带结构图、载流子浓度分布图、载流子复合率分布图等剖析Al组分影响器件光电特性物理机制,利用Origin专业数据.处理软件对仿真结果进行处理,形成实验报告。


 您还未完善您的
您还未完善您的


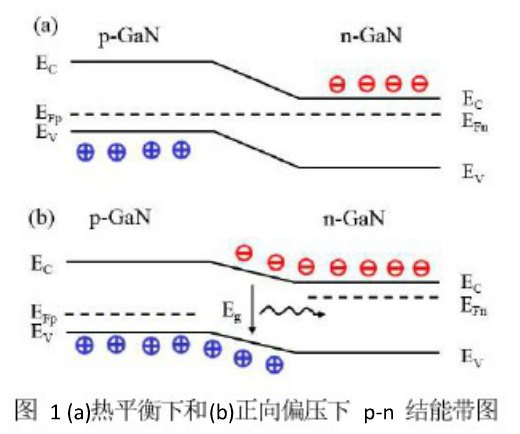
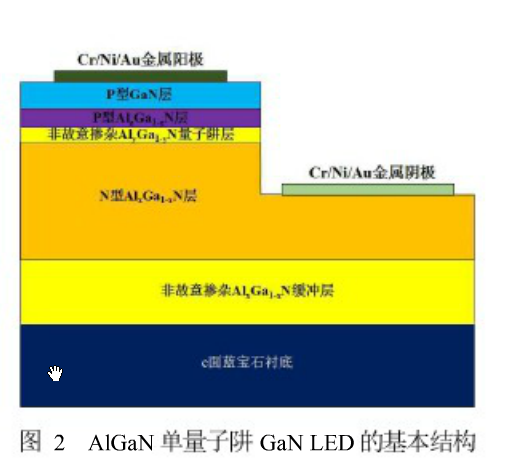
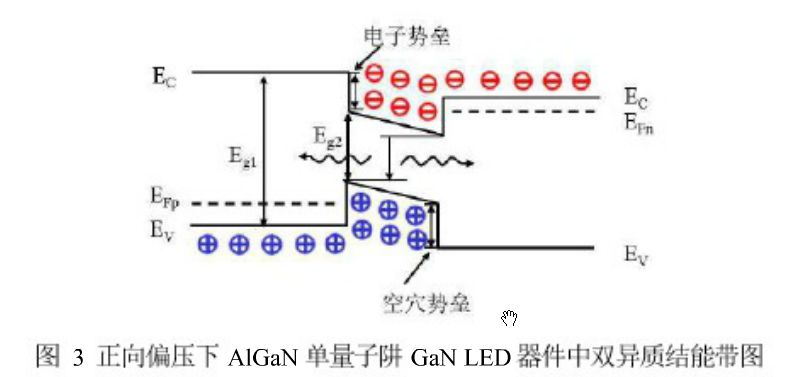
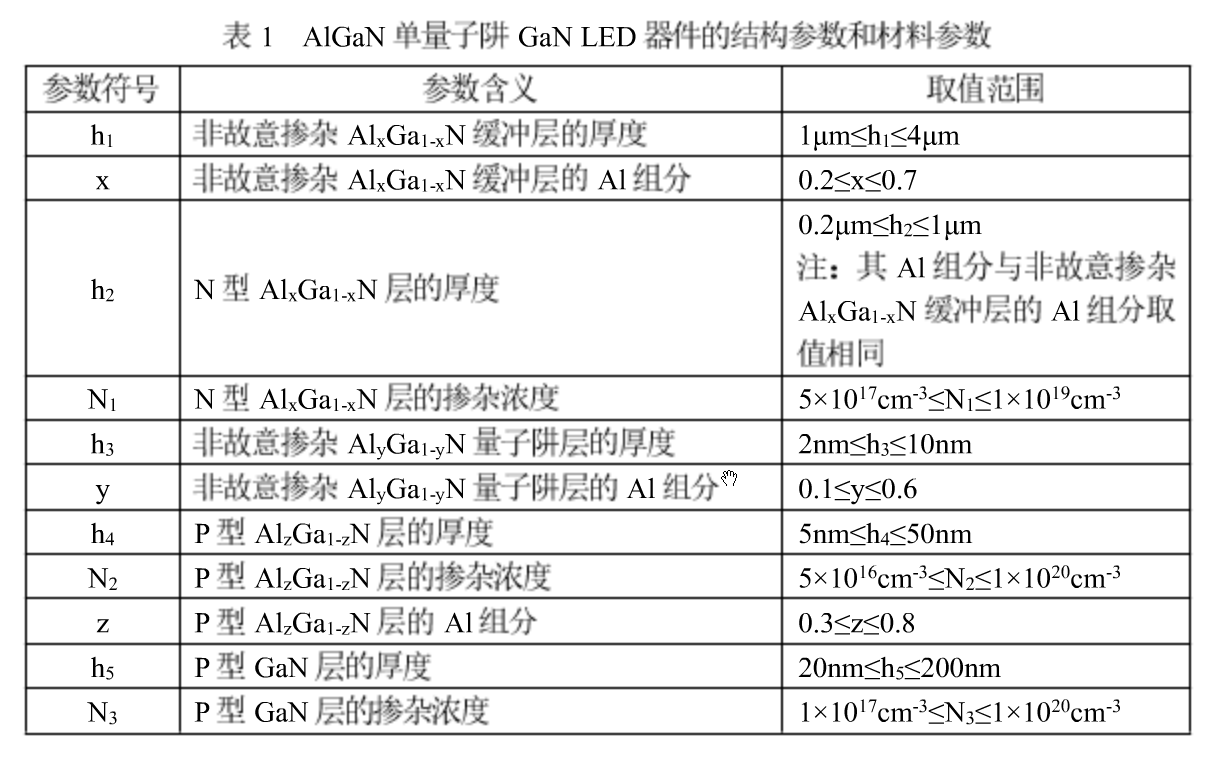

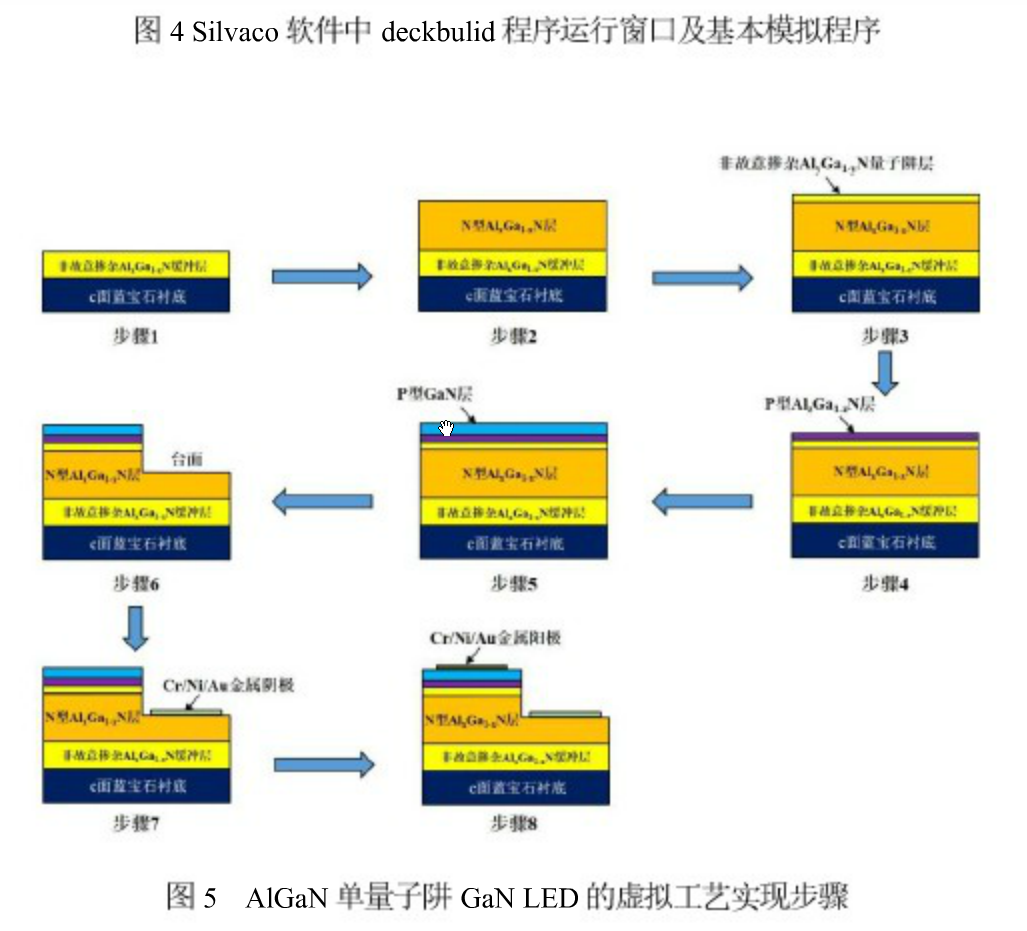
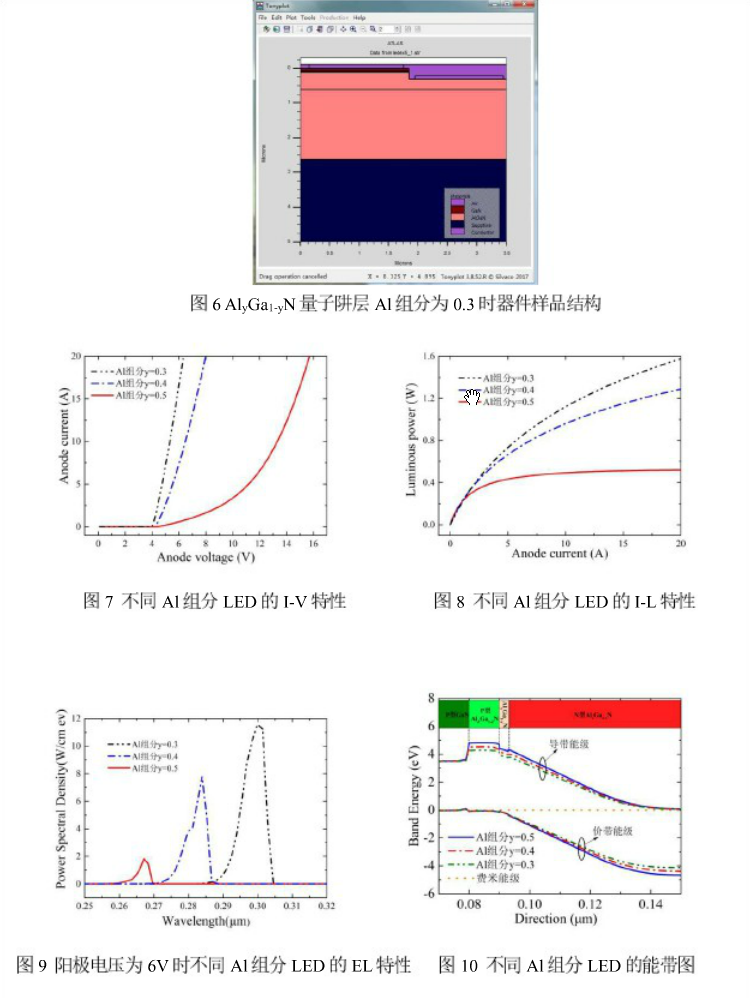
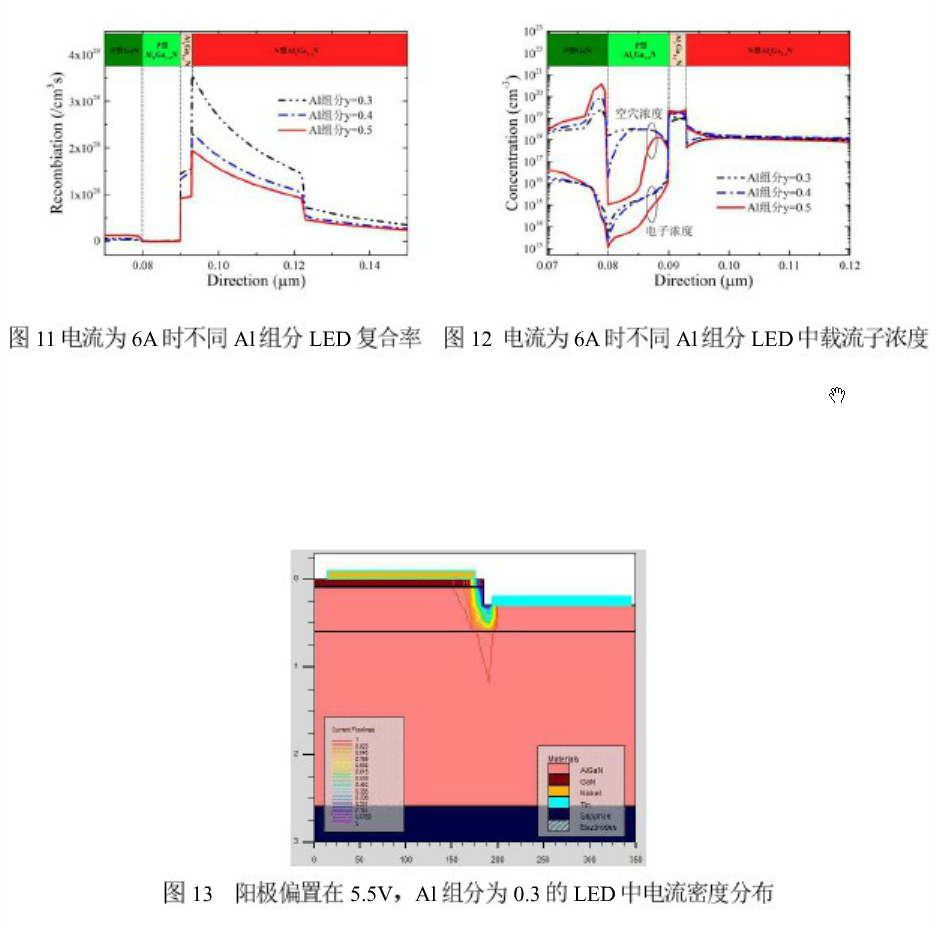

 0
0 0
0



